AFM (Rasterkraftmikroskop)
Grundlagen
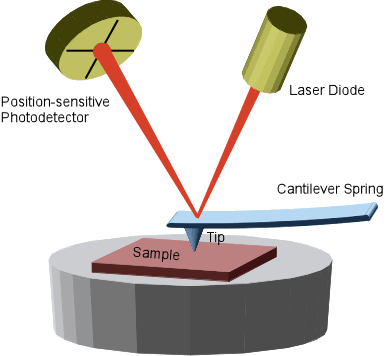
Das Rasterkraftmikroskop (AFM - Atomic Force Microscope) ist ein Typ der Rastersondenmikroskope (Scanning Probe Microscope). Mit dem AFM können Oberflächenstrukturen und -eigenschaften im nm- und sub-nm-Bereich abgebildet und Oberflächenkräfte im der Größenordnung 0.1-1nN gemessen werden.
Ein Rasterkraftmikroskop enthält im allgemeinen eine mikroskopische Spitze (Spitzenradius ~10-50 nm), welche an einer Balkenfeder (Cantilever) befestigt ist. Bei Annäherung an die Oberfläche kommt es zu einer attraktiven oder repulsiven Wechselwirkung zwsichen Oberfläche und Sondenspizte. Diese Kraft wird von der Spitze auf die Balkenfeder übertragen und bewirkt eine Auslenkung der Balkenfeder. Mittels Piezokristallen kann die Sondenpitze in alle drei Raumrichtungen bewegt werden. Für eine Abbildung der Oberfläche wird diese mit der Spitze rasterförmig abgetastet.
Um die Auslenkung der Balkenfeder zu messen, wird ein Laserstrahl verwendet, der dann entsprechend der Federkrümmung mit unterschiedlichen Winkeln zu einer ortssensitiven Photodiode reflektiert wird. Die Ausgangsspannung dieser Photodiode ist proportional zur Auslenkung der Feder.
Kraftmessung
Um Information über die Oberflächenkräfte an einer bestimmten Stelle der Probe zu erhalten benutzt man den Force Mode. Dabei wird die Spitze der Probe angenähert und wieder entfernt. Wird das Photodiodensignal als Funktion der Auslenkung der z-Piezos aufgenommen, erfhält man eine Kurve die als Kraft-Abstandskurve interpretiert werden kann.
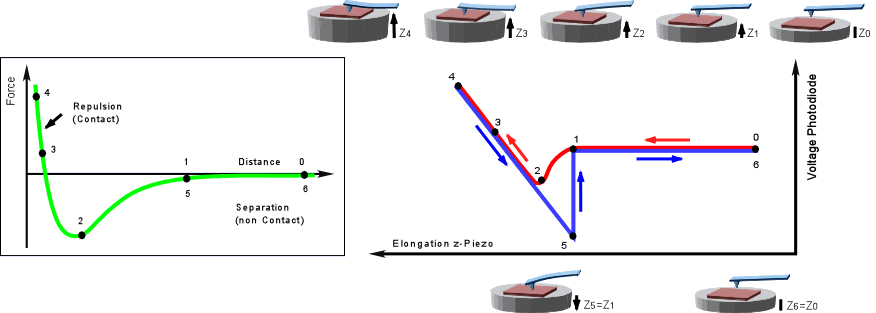
Nimmt man für die Wechselwirkung zwischen Spitze und Probe ein Lennard-Jones-Potential an, kann ein Nähern/Entfernen-Zyklus folgendermaßen beschreiben werden:
(0) Die Spitze ist weit entfernt und es wirken keine Oberflächenkräfte.
(1) bis (2): Während die Spitze sich annähert, kömmt sie in der Bereich der attraktiven Oberflächenkräfte und wird zur Probe hin gebogen.
(2) bis (4): Die Spitze ist in Kontakt mit der Oberfläche und übt Druck auf diese aus, während sie selbst nach oben duchgebogen wird.
Ab (4) wird der Federbalken zurückgezogen, jedoch kann die Spitze durch Adhäsionskräfte weiter an die Oberfläche gebunden sein, solange bis die Federkraft größer als die Adhesionkraft ist (5). Dann springt die Spitze zurück in die Ursrungslage, und der Zyklus kann erneut gestartet werden (6).
Oberflächenabbildung
Im einfachsten Modus, dem Kontaktmodus, wird die Sondenspitze auf die Probe abgesenkt, was zu einer Durchbiegung der Feder führt. Beim Abtasten der Oberfläche wird diese Auslenkung mittels PID-Regler, der das Piezostellelement bewegt, konstant gehalten. Der Nachteil dieser Methode ist, dass Scherkräfte auf die Probe ausgeübt werden, die ihrerseits die Oberflächenstruktur beeinflussen können.
Für weiche Proben wird deshalb im allgemeinen der sogenannte Tapping-Modus verwendet. Hierzu wird die Balkenfeder in der Nähe ihrer Resonanzfrequenz (~300kHz) zu Schwingungen angeregt und der Oberfläche angenähert. Kommt die Sondenspize dabei in die Reichweite des Wechselwirkungspotenzials, so verschiebt sich die Resonanzfrequenz, wodurch sich die Amplitude der angeregten Schwingung verringert. Wird die Höhe der Spitze über der Probe so geregelt, dass die Dämpfung stets konstant bleibt, dann ergibt die Auftragung der Z-Piezo Werte gegen den Ort eine Abbildung der Oberflächentopographie.
Die Auflösung, die mit einem Rasterkraftmikroskop erzielt werden kann, liegt bei 0,1 bis 10 nm.
